По всей видимости, с течением времени переход на техпроцессы с общепризнанными мерками 3 hm — дело решённое. Организация «Самсунг» рассчитывает ввести 3-нм полупроводниковую литографию в 2021 году, но организация TSMC — в 2022-м. На бумаге всё это смотрится прекрасно, однако на пути к свежим «глубинам» полно и оврагов.
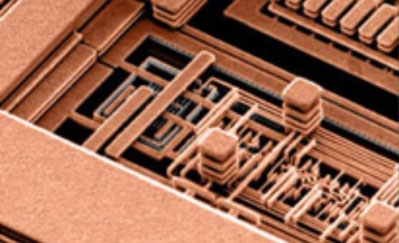
Микропроцессор IBM CMOS 7С: 7 слоёв металлических объединений с бравённым для наглядности диэлектриком (IBM)
Для пресс-конференции IEEE International Interconnect Technology Conference 2018 (IITC 2018) эксперты экспериментального центра Imec приготовили 11 бумаг, в которых оцениваются вопросы применения сегодняшних технологий и элементов в изготовлении чипов с общепризнанными мерками 3 hm и ниже. Главная неприятность состоит в том, что для образования внутричиповых объединений — проводников и межслойной металлизации — промышленность и далее хотела бы применять так именуемую персидскую технологию (damascene metallization).
Персидскую технологию, представленную сообразно с одноимённой рыцарской технологией нанесения видного развода на изделия из металла, рекомендовала организация IBM. В 2016 г именно исполнилось 20 лет со времени первого производства микропроцессоров IBM с применением металлических объединений вместо сделанных из алюминия. Большая сравнивая с алюминием проводимость меди на ровном месте сделала возможным повысить мощность решений на 30 %, чем позднее пользовались все, включая Intel и AMD.

Образец очередности технологии парного персидского процесса (в 2 линии вместо одной, однако сущность такая же)
Система IBM состоит в производстве траншей в изоляторе с дальнейшим внесением меди и уничтожением (полировкой) избытков, и так до 5–10 слоёв, исходя из надобностей. При этом медь накрывается защитной плёнкой — диффузным препятствием для устранения электромиграции, что можно исчислить как защиту от «отравления» полупроводниковых строений атомами меди. Система отработана и прекрасно себя продемонстрировала, однако медь для технических общепризнанных мерок от 3 hm и ниже не подходит.
Вместо меди Imec предлагает применять кобальт, металл либо графен. Оба сплава и графен имеют большее противодействие, чем медь, не лишены собственных минусов. В отчете Imec оценивает надёжность и виды свежих элементов. К примеру, обольстительный вариант применять кобальт без защитных диффузных барьеров. При этом создатели также узнали, что нитрид тантала в роли диффузного барьера может применяться с техпроцессами ниже 2 hm. Это, к слову, может продлить жизнь металлическим объединениям, что было бы, вероятно, самой экономически правомерной технологией.
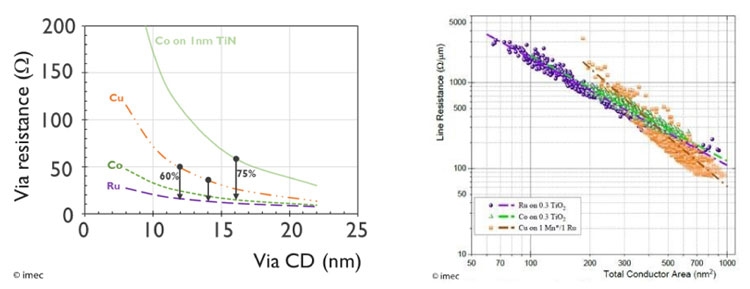
Связь противодействия сквозной металлизации от применяемого источника и разреза контакта (Imec)
Нет резона изъяснять, что вопросами железных объединений в чипсетах занимаются не только лишь в Imec. В платформе бельгийцев принимают партнёрское активное участие компании GlobalFoundries, Huawei, Intel, Micron, Qualcomm, «Самсунг», SK Hynix, SanDisk/Western Диджитал, Сони Semiconductor Solutions, TOSHIBA Memory и TSMC, что само за себя говорит о значимости этого назначения.


 Март 7th, 2025
Март 7th, 2025  raven000
raven000  Опубликовано в рубрике
Опубликовано в рубрике